����z����ӹ��I�в��ɻ�ȱ�ĺ��Ļ��A���ϡ���оƬ�������ӹ��^���У����^�����g�̡����e���s�γ���K���{�������·�������ع�^�����@Ӱ�^���е�ȥ�����������Ԍ���֞����Թ���z��ؓ�Թ���z�ɴ��
�������̼��g����������ع��Դ����ͻ������������Ч���ľ��ޣ���Փ�Ͼ��и��ߵķֱ��ʡ����⣬�������̼��g�o����Ĥ����M��ֱ���ع⣬��ˏV�������ڴ�Ҏģ�����·���õ���Ĥ�����죬������ИI�����{�Y��ǰ���_�l���ɻ�ȱ�Ĺ�̼��g��Ŀǰ���Ј��ϳ��õ��������������z����PMMA950��ZEP520��ؓ�z��Ҫ��HSQ��SU-8���z�N��Ŀǰ���������������z��Ҫ�����́��ԇ��⣬�����Ȱ댧�w�S�̎�ռ���ˇ���ȫ�����Ј���

���꣬�㽭��W��V���о��T�n�}�Mͨ�^���W�ƽ��棬�״�̽���ˌ�������̼����̼����(CO2-PC��������̼�ͭh����N�Ľ��湲����)������ӹ�̲��ϵđ��á�2017�꣬�����OӋ��AB�ͱ���ϩ-̼�������Ƕ�ι�����(PS-b-PPC)��������Å�����Ŀǰ���I�糣�ñ���ϩ-����ϩ�����Ƕ�ι�����ăɱ�֮�࣬���������ù��I����A�ğ��˻�ˇ�ڻ��W�D���Ͽ��ٌ��F�����̣��m������һ��< 10 nm���c̎������������Nano Lett., 2017, 17, 1233�C1239�������ڣ������Mһ���OӋ�ϳ��˰빝��6�{��ABA�ͱ���ϩ-̼�������Ƕ�ι����ͨ�^���H���Ⱥ��������F�˼����·���û����D�ε��g��(Nat. Commun., 2020, 11, 4151)������������c������Ķ�λ�о��߂��ٴκ����������㽭��W���ϵ��n�}�M��֥�Ӹ��W���ӹ��̌WԺNealey�n�}�M���͵���W��ӌWԺ��Ԋʥ�n�}�M�ȣ����_�l�˾��и��`���ȵ����Ժ�ؓ�Զ�����̼����̼�������������z������`�����_��1.3 ��C/cm-2������R��ߴ���29 nm���Լ��^�͵�4.6 nm�ľ�߅���ֲڶȡ����P�ɹ��ԡ�CO2-Based Dual-Tone Resists for Electron Beam Lithography�����}�ھ��l����Adv. Funct. Mater. 2020, doi: 10.1002/adfm.202007417.

Scheme 1. The synthetic routes and patterning procedures of CO2-based positive and negative resists
�о�������Ԕ���о���6�N���в�ͬ���W�Y���Ķ�����̼����̼�����������������z��Scheme 1�������У������p�I�Ȼ��ľ�4-��ϩ���h��ϩ̼������PVCHC���;ۙ���ϩ̼������PLC����������ع����l�������@Ӱ�����ڻ�Ƭ���棬�M������ؓ�zʹ�á��۱�ϩ̼������PPC�����۱���ϩ̼������PSC�����ۭh��ϩ̼������PCHC���;ۙ���ϩ�p̼������PLDC����朵�̼�����I�������ݗ�Օ��l�����⣬�عⲿ���ܽ����@Ӱ���У��ɞ���͵������z�N���о��߂�ͨ�^NRT��Normalized Remaining Thickness������������̽���˻��W�Y�����ۺ�����������@Ӱ�������،������������ܵ�Ӱ푡��������z���ԣ��ۺ���Ą���Խ����������ԽС���`����Խ�ߣ��@��Ҫ�����ۺ�����朄��Ե���ߕ�ʹ���z���Ӹ����ה��ѣ����������^С�ľۺ�������������Զ�朻�С���ӡ���֮��ؓ�z��������ع⽻�^���Е��ܵ�朄��Ե����ƣ���Ҫ����Ą���ʹ֮�����γɷ����ĈD����������ԽС�t��Ҫ����Ą����γ����Ľ��ȣ��M�����@Ӱ�^���б���Ԍ����{�Y����Table 1����

Table 1. The physicochemical and EBL performance of CO2-derived negative and positive resists.
���]���z�N�ľC�����ܺ�ȫ�Gɫ��Դ�ă��c�������x�þۙ���ϩ̼������PLC���;ۙ���ϩ�p̼������PLDC������ģ�Ͳ����M��������̽�������������@�ɷN���Ϸքe�Ƃ���ؓ�Ժ����Թ�ţ��빝��HP: 100 nm��ռ�ձȞ�1:1��L/S������ͬ�ĈA��HP: 100 nm��L/S�������T���ǣ�40���ڣ��Y������ؓ�z�N���R��ߴ�;�߅���ֲڶȷքe�_����29/58�{��4.6/26.7�{��(Figure 1)��

Figure 1. The negative and positive SEM images of nanopatterns constructed.
����̽��������̼����̼��������z���ع��^���еĻ��W׃�����о�����PLC��PLDC���о������������ع�C���M����Ԕ���о�������ͨ�^�@�t����V�x���ع�^��Ĺ���z�M�Мyԇ���l�F���zPLDC��机͂��̼�������F���ʻ��壨1756 cm-1/ 1815 cm-1�����ڸ߄����ع�����u��ʧ������������xԴ��EI�����|�V�xģ�MPLDC��������µ��ع��^�̣��z�y������Ƭ�@ʾ���g��44 Da���x�ӷ壬��������������Z���£�PLDC̼�����I�l�������ݳ�������̼���ӡ�ؓ�zPLC������������^�ߵ��p�I�ܶȺ�朄��ԣ���С�������ع��²������l����朵Ĕ��ѣ���10 ��C/cm-2��100 ��C/cm-2�Ą����£������z�y�@ʾ�p�I�����Տ���ֻ�քe�½���15%��37%�����@ʾ�����Ľ��Ⱥ�̱���� (Figure 2)��
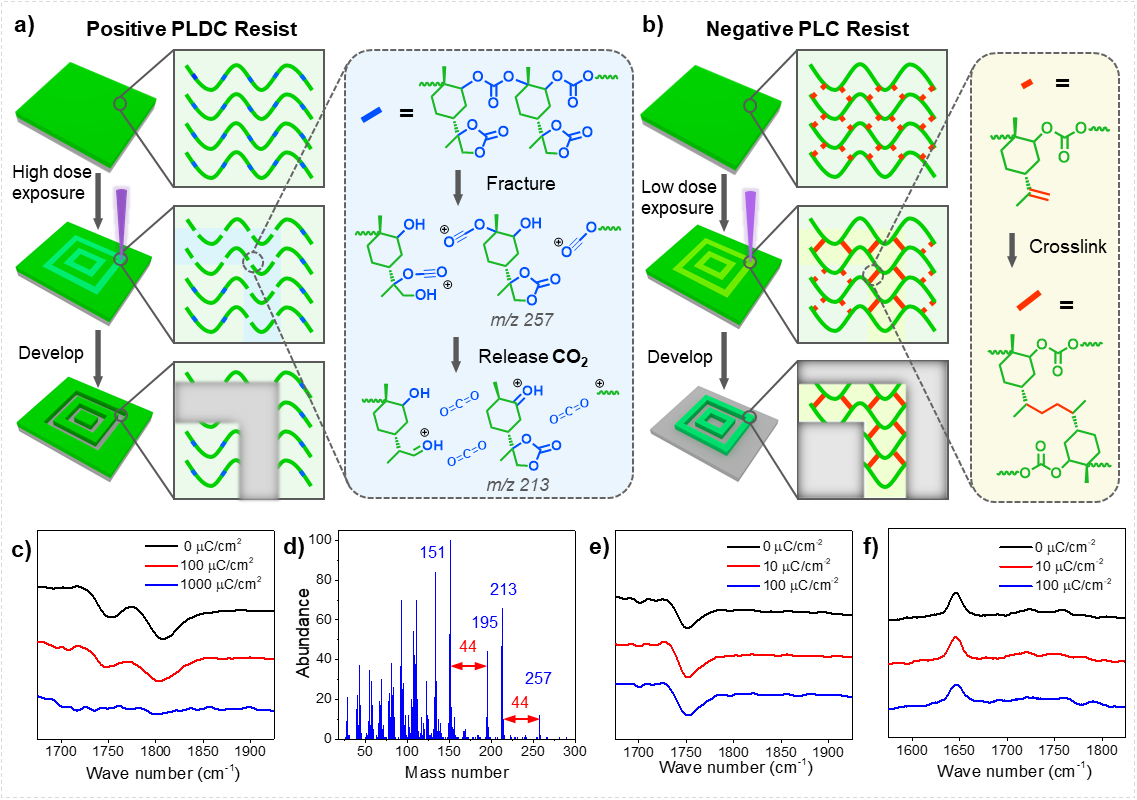
Figure 2. The reactions and characterizations for the positive and negative resists during e-beam process.
������ߞ����C���_�l�Ĺ���z�Č�����߀�cĿǰ���۵����������z�M����Ԕ���ļ��g�����ϵČ��ȣ����ּ��g�������^�����۵��z�N��ͬ�r�������Mһ�����ö�����̼����̼�������������z�քe�ӹ����������Ժ�ؓ�ԵĶ��S���Ӿ��w���������������ֱ���ķ�ʽ�ڹ��Ӿ��w�D���Ϸքe�̌������ڞ�500/600/700 nm���ķ��cꇽY�� (Figure 3)���Y���������ɷN���Ӿ��w�ڰ�ļ��l�£��@ʾ�������ĽY��ɫ�����]����̼�������и����Ժ͵������ʣ��ڹ�W�I����T�����ã����P����W���R�ȣ����@һ�Y��Ҳ�Mһ���C���˶�����̼����̼�������������z���õđ���ǰ����
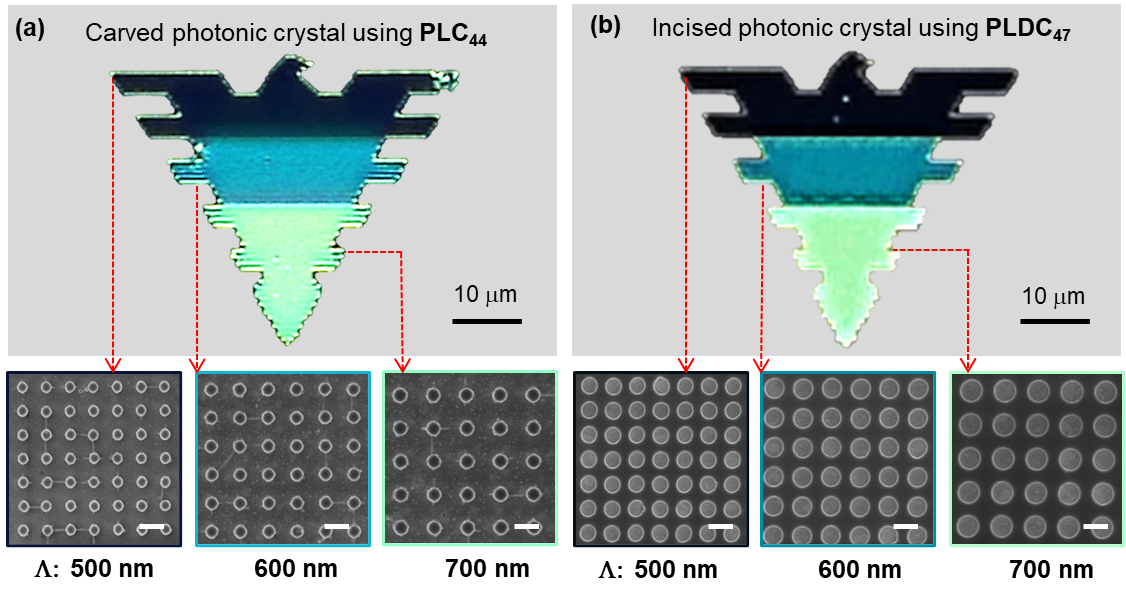
Figure 3. Embossed and intagliated photonic crystal devices using the negative/positive resists, respectively.
�о��߂�̽���ˌ�������̼����̼����������ؓ���������z���ϵ�����;��Ԕ���������仯�W�Y�������������@Ӱ�������،������������ܵ�Ӱ푣����F�˸߷ֱ����{�D�����g�̣��о��˶�����̼����̼��������z���ع�C��������ع�l������������ؓ����z�քe�Ƃ��˃ɷN���S���Ӿ��w�Y�������]��������̼�����Ͽ�Ҏģ���Ƃ䣬�c�F�м��g���õļ����ԣ����{���`���ȡ��ֱ��ʺ͵;�߅���ֲڶȵȃ��c���@����͵��z�N���{���������ǹ����Ĥ��������о������õđ���ǰ����
1�������о��õ��˾��͌����˵ķe�O�u�r����The paper is timely, as the semiconductor mask making industry is embracing lower sensitivity, non-chemically amplified resists for EUV mask making. This change makes resists such as these more competitive for production applications in addition to R&D work.�� (�@��о��Ǽ��r�ģ����댧�w�ИI�������ڲ��õ��`���ȡ��ǻ��W�Ŵ�Ĺ���z���Ƃ�O������(EUV)����ģ�档���`���ȵĹ���z�_�l��ʹ���P���аl�����a�͑��ø��߸�����)��
2�������Mһ�������z�N���|������V���о��T�n�}�M����߀�_�l��ϵ�о��и��Եğo���ٴ��������Ƃ������̼�����ϣ�J. Am. Chem. Soc., 2020, 142, 12245�����o���ٴ�����ʹ�ÿ���Ч������Ӽ����WƷ�Ƃ���ٚ��������_�����P�о�Ҳ�����Mһ����������z��Ʒ�|�ṩ�˿����ԡ�
3����ԓ��������Ҫ�о��߽�B�������漰�����W����W����ӌW�Ķ��W�ƽ���ͼ��g�\�ã��@һ�о�ǰ�v������r�g���õ��ˇ��H���ȶ�λ�����ߵ��L��֧�ֺ͎�����ԓ�ɹ�����2017����ύ��Ո���Ї��l�����������ڽ�������֪�R�a�ࡶZL201711248838.2��һ�N��̼�����������������z���ϵđ�������
Փ��朽Ӻ���Ϣ��CO2-Based Dua-Tone Resists for Electron Beam Lithography, Xin-Yu Lu, Hao Luo, Kai Wang, Yao-Yao Zhang, Xiao-Feng Zhu, Dongxue Li, Bingze Ma, Shisheng Xiong, Paul F. Nealey*, Qiang Li,* and Guang-Peng Wu*, Adv. Funct. Mater. 2020, doi: 10.1002/adfm.202007417.
https://onlinelibrary.wiley.com/doi/10.1002/adfm.202007417
- �пƴ��ȘI��/�����n�}�M Nat. Commun.��S/O���p�I�p�خ������ӵ���x���_�h�ۺϲ����Ƃ�����CO?������������ 2025-10-30
- �����V������n�}�M Angew����ˮ�@Ӱ�ĸ����ܶ�����̼�����W�Ŵ����z 2024-09-27
- ����ʯ�ʹ�W��������ڈF� CEJ�����г־ÿ������������ϻ����ܵĶ�����̼����̼�����ľGɫ���� 2023-11-19
- �����V������n�}�M Angew���ЙC��朴���ۺ��ƄӶ�����̼��̼����������������ԇ���a��� 2025-10-26
- �㹤���������/�R�����ڈF� Small: ���г�����ȼ������ȱ�ڛ_���g�Եľ�̼���� 2025-08-12
- �Ĵ���W����о��T/���������ڈF� Macromolecules���̼�푑������OӋ���F���յ���ȼ��̼���� 2025-07-29
- �����V���������� ACS Nano����߸߷����Ժ��`���ȵĘO����������������������z 2025-10-31
